전영현 DS부문장, AVP 개발팀 꾸려 직속으로 편입'비욘드 무어' 이끌 반도체 패키징···조직 역량 집중패키징 성능 150% 향상시킨 HCB 3D, 내후년 출격
삼성전자의 AVP(Advanced Package) 사업팀은 비욘드 무어(Beyond Moore) 시대를 이끌기 위해 지난 2022년 12월 출범했다. 이곳은 메모리와 파운드리(위탁생산) 사업부에서 생산한 웨이퍼를 바탕으로 반도체 패키징의 구조와 성능, 설계까지 고객사의 요구에 맞춰 커스터마이징(맞춤형) 하는 것을 주요 목적으로 한다.
7년 만에 삼성전자 DS(디바이스솔루션)부문으로 복귀한 전영현 부회장은 최근 조직 개편을 단행하며 AVP 사업팀을 개발팀으로 재편해 직속으로 편입시켰다. 반도체 성능은 회로를 얼마만큼 미세화하는지가 핵심인데 반도체의 성능이 2년마다 2배씩 높아지는 '무어의 법칙'에 한계가 오면서 패키징에 대한 중요성이 커지고 있기 때문이다.
기존(Conventional) 패키징은 웨이퍼를 먼저 칩으로 자른 뒤 적층해 전기적 신호를 연결했다면 어드밴스드 패키징은 웨이퍼 위에서 로직과 메모리를 함께 묶어 '이종 집적화'하는 것이 특징이다. CPU(중앙처리장치)와 GPU(그래픽저장장치) 등 로직칩과 메모리가 각각 따로 놀았으나 칩들을 효율적으로 배치해 하나로 동작하게 함으로써 패키지 안에 더 많은 트랜지스터를 집적할 수 있는 것이다.
신설된 AVP 개발팀은 2.5차원(D), 3D 등 신규 패키지 기술 개발에 집중할 것으로 전망된다. 특히 고대역폭 메모리(HBM) 경쟁력에서 뒤처져 있는 만큼 엔비디아를 고객사로 확보하기 위해서라도 패키징 경쟁력을 끌어올려야 하는 상황이다. 삼성전자는 자체적으로 2.5D 패키지를 'I(Interposer)-Cube'와 'H(Hybrid)-Cube' 등으로, 3D는 'X(eXtended)-Cube' 등으로 명명하고 있다.
현재 AI 칩 패키징은 실리콘 인터포저(Interposer) 라는 특수 기판 위에 GPU와 HBM을 수평으로 연결하는 2.5D 방식이 가장 많이 쓰인다. HBM을 패키지 기판과 연결하려면 구 형태의 돌기를 뜻하는 범프(Bump)가 쓰이는데 AI 칩은 범프 수가 수만 개에 달해 HBM을 기판 위에 바로 붙이면 패키지 밖 시스템으로 나가는 신호에 병목 현상이 생길 수 있어 인터포저를 필수적으로 쓰고 있다.
3D 패키징은 HBM 아래 GPU가 위치하는 식이다. 두 칩이 옆으로 놓이지 않고 수직으로 연결되는 만큼 전체 칩 면적을 줄이면서 전력 효율은 높이고 고객사의 설계 자유도를 높일 수 있는 점이 특징으로 꼽힌다. 업계에선 이르면 7세대 HBM인 HBM4E부터 3D 패키징이 본격적으로 활용될 것으로 보고 있다.
삼성전자가 지난 2020년 업계 최초로 테스트 양산에 성공한 'X-Cube'는 EUV(극자외선)를 활용한 7나노(㎚·1나노=10억 분의 1m) 로직 칩에 3D 패키징 기술을 적용 점이 특징이다. 삼성전자는 X-Cube를 활용하는 고객사의 경우 7나노를 비롯해 EUV 기술 기반 5나노 칩 개발을 바로 시작할 수 있다고 설명한다. 또 사측은 5나노뿐만 아니라 4나노, 3나노 등 선단 공정까지 X-Cube를 확대 적용할 계획이다.
3D 패키징에는 HCB(Hybrid Copper Bonding)까지 적용하기로 했다. 지난 2022년 IEEE(전기전자공학자협회)에서 발표된 HCB는 칩과 칩을 별도의 범프 없이 연결하는 기술로 구리(전도체)와 산화막(절연체)을 이용한 접합 방식을 뜻한다. 삼성전자에 따르면 이 기술을 적용할 경우 3D 패키징 성능은 기존보다 최대 150% 향상돼 데이터 전송 속도를 더욱 빠르게 끌어올릴 수 있다. 삼성전자는 이를 2026년 선보일 예정이다.
관련기사

뉴스웨이 김현호 기자
jojolove7817@newsway.co.kr
저작권자 © 온라인 경제미디어 뉴스웨이 · 무단 전재 및 재배포 금지





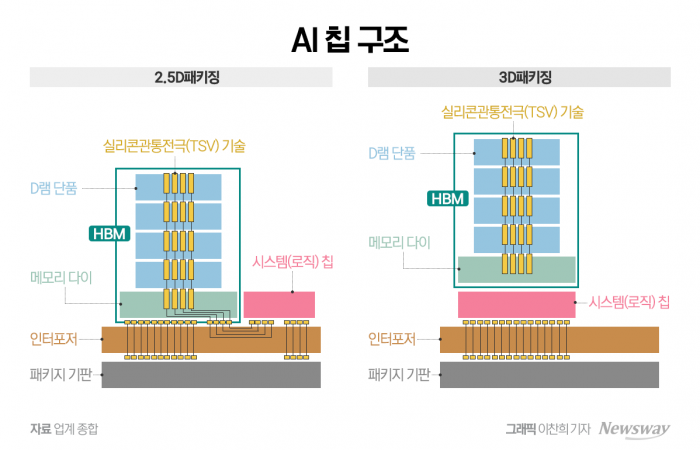



댓글